技术领域
本发明涉及半导体器件设计领域,具体涉及一种LDMOS场效应管及其制备方法。
背景技术
LDMOS场效应管,即横向扩散金属氧化物半导体器件。随着对击穿电压要求的提高,对LDMOS场效应管中场板要求也高。
现有的LDMOS场效应管,在制备过程中,由于结构限制,场氧化层与浅氧化层的交界位置氧含量较低,导致生长速度慢,场氧化层和浅氧化层交界的位置出现一薄弱的击穿点,该击穿点将在一定程度上降低LDMOS器件的击穿电压,即降低了LDMOS器件的耐压水平。
目前,对该击穿点的优化通常是将场氧化层与浅氧化层共同形成的场板面积增大,提升场效应管的整体耐压水平,此举直接影响是场效应管的面积对应增加。这种改进,毫无疑问会增加材料,从而增加制造成本,且击穿点依然存在于场氧化层与浅氧化层之间的交界位置附近,并未从根本上优化该击穿点。
发明内容
针对现有技术的不足,本发明的目的在于提供一种LDMOS场效应管及其制备方法,旨在通过优化场氧化层和浅沟槽氧化层交界附近位置薄弱击穿点,无需增加场板面积即可有效提升LDMOS场效应管的耐压水平。
本发明提供一种LDMOS场效应管的制备方法,方法步骤包括:
1、提供半导体衬底,对半导体衬底进行刻蚀以得到若干个沟槽区。衬底的材质为硅、碳、锗、镓和砷中的一种或多种。单晶、多晶或非晶结构。

2、在沟槽区内形成介质层,使介质层覆盖于沟槽区的底面与侧壁。
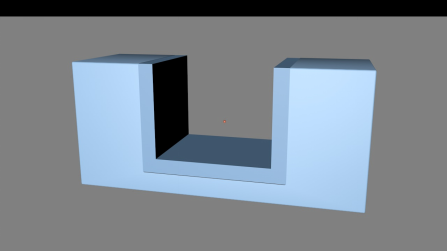
3、对沟槽区内的介质层进行离子注入。注入成分包括碳离子与氢离子。具体细分为:
(1)控制半导体衬底进行转动,在半导体衬底转动的过程中,对转动的介质层进行离子注入;
(2)沿预设方向逐渐改变对介质层的离子注入位置;
(3)位置改变的同时,逐渐改变注入能量,以在介质层内的预设深度形成倾斜的、向下厚度递增的离子改性层。介质层的倾斜角度为77°―83°。此步骤又具体包括:
1)将离子注入设备的离子注入端对准沟槽区的底部,以一初始离子注入剂量、初始离子注入能量对介质层的底部进行离子注入;
2)控制半导体衬底进行转动;
3)控制离子注入端朝着沟槽区的顶部逐渐移动,并在逐渐移动的过程中减少离子注入剂量以及离子注入能量;
4)或者,将离子注入设备的离子注入端对准沟槽区的顶部,以一初始离子注入剂量、初始离子注入能量对介质层的顶部进行离子注入;
5)控制离子注入端朝着沟槽区的底部逐渐移动,并在逐渐移动的过程中增加离子注入剂量以及离子注入能量。
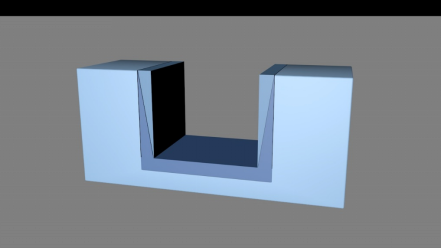
4、对离子改性层刻蚀,随着深度增加,该离子改性层的厚度递增,且顶部齐平于半导体衬底的表面。离子改性层的倾斜角度为77°―83°。由于离子注入,改变了介质层内某一深度区域的属性,如硬度的提升。在对介质层刻蚀时,刻蚀至离子改性层后,无法进一步深入,刻蚀被截止,从而精准控制介质层的刻蚀深度。
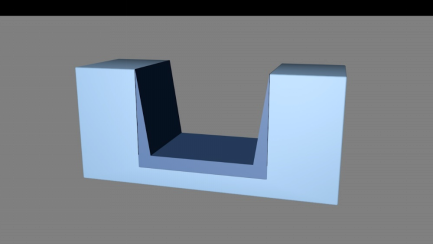
5、采用热氧化工艺,按照第一热氧化条件,在沟槽区内的离子改性层之上形成浅氧化层,使浅氧化层的顶面低于介质层的顶面。此步骤又具体包括:
1)采用热氧化工艺,按照第一热氧化条件,在沟槽区内的介质层之内形成浅氧化层;
2)对浅氧化层的顶部进行刻蚀,使浅氧化层的顶面呈水平,且低于周围介质层的顶面。
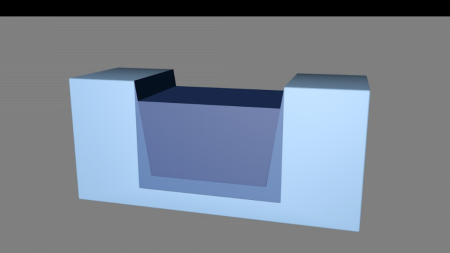
6、采用热氧化工艺,按照第二热氧化条件,在半导体衬底与浅氧化层之上沉积场氧化层,使场氧化层于沟槽区内的底面低于介质层的顶面,形成LDMOS场效应管的场板。此步骤又具体包括:
1)采用热氧化工艺,按照第二热氧化条件,在半导体衬底与浅氧化层之上沉积场氧化层;
2)控制场氧化层于半导体衬底之上的厚度等于浅氧化层与半导体衬底表面的高度差。
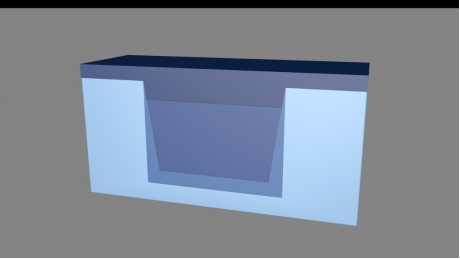
7、其中,第一热氧化条件与第二热氧化条件均包括温度条件、氧含量条件与氧流速条件。具体要求是:第一温度小于第二温度,第一氧含量高于第二氧含量,第一氧流速高于第二氧流速。
有益效果
实现对LDMOS纵向耗尽的调节,进而提升LDMOS场效应管的BV水平。浅氧化层与场氧化层交界的附近位置并非尖角,能够有效的优化浅氧化层与场氧化层之间的薄弱击穿点,不再需要将场板加大,也就不需要被动的增加芯片面积,提升了LDMOS场效应管的耐压水平。
实验结果分析

参数
实施例介质层的倾斜角度第一温度(C)第一氧流速(m/s)第一氧含量(氧氢比)第二温度(C)第二氧流速(m/s)第二氧含量(氧氢比)BV值(V)
在本发明中,通过降低介质层的倾斜角度,在其它参数不变的情况下,LDMOS场效应管的BV值具有一定的提升,当然,介质层的倾斜角度并非越小越好,通常限制于75°以上;而在介质层的倾斜角度相同、第一氧流速与第二氧流速更大的情况下,LDMOS场效应管的BV值更大;而在同时降低介质层的倾斜角度,增加第一温度、第一氧流速以及增加第二温度、第二氧流速时,LDMOS场效应管的BV值提升较为明显,如第五实施例,其BV值达到峰值;相反的,对比例中由于场氧化层与介质层无接触,即使在制备参数不变的情况下,其BV值也略有下降。
综上,在本发明所示的LDMOS场效应管的制备过程中,通过降低介质层的倾斜角度,以及提升浅氧化层、场氧化层制备过程中的温度与氧流速,能够有效提升LDMOS场效应管的器件耐压。